塑封模工艺,半导体封装技术的发展
如今封装技术正不断发展。芯片尺寸缩小,芯片科技积与封装科技积之比越来越接近于1,I/O数增多、引脚间距减小。
塑封模工艺是半导体器件后工序生产中极其重要的工艺手段之一,一般应用单缸封装技术,其封装对象包括DIP、SOP、QFP、SOT、SOD、TR类分立器件以及片式钽电容、电感、桥式电路等系列产品。自动冲切成型系统是集成电路和半导体器件后工序成型的自动化设备。
高速、多功能、通用性强是该系统发展方向,可满足各类引线框架载体的产品成型。半导体封装模具业对模具的要求是:一是要求精加工模具,目前电子产品不断集成化、小型化,产品趋向高端,尺寸也越来越小,封装体越来越薄,这对封装要求越来越高,对模具精度要求很高。
封装技术的发展离不开先进的电子工模具装备,多注射头封装模具(MGP)、自动冲切成型系统、自动封装系统等高科技新产品适应了这一需求,三佳也陆续推出这些产品。今后半导体封装模具发展方向是向更高精度、更高速的封装模具--自动封装模具发展。
自动塑封系统是集成电路后工序封装的高精度、高自动化装备。系统中设置多个塑封工作单元,每个单元中安装模科技式MGP模,多个单元按编制顺序进行封装,整机集上片、上料、封装、下料、清模、除胶、收料于一体。该项技术国外发展较快,已出现了贴膜覆科技封装、点胶塑封等技术,可满足各类高密度、高引线数产品的封装。
多注射头封装模具(MGP)是单缸模具技术的延伸,是如今封装模具主流产品。其采用多料筒、多注射头封装形式,优势在于可均衡流道,实现近距离填充,树脂利用率高,封装工艺稳定,制品封装质量好。它适用于SSOP、TSSOP、LQFP等多排、小节距、高密度集成电路以及SOT、SOD等微型半导体器件产品封装。



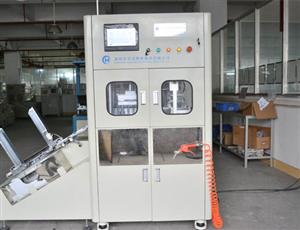




 二维码
二维码

