IC封装、半导体封装在集成电路上的广泛应用
由于电子整机对半导体自动化设备器件与集成电路的封装密度和功能的需要,未来必须加快速度发展新型先进电子封装技术,包括芯片尺寸封装(CSP)技术、焊球陈列封装(BGA)技术、芯片直接焊(DCA)技术、单级集成模块(SLIM)技术、圆片级封装(WLP)技术、三维封装(3D)技术、微电子机械(MEMS)封装技术、表面活化室温连接(SAB)技术、系统级芯片(SoC)封装技术、系统级封装(SiP)技术、倒焊接(FC)技术、无铅焊技术等
从技术发展趋势来看,由于半导体市场对于封装在小尺寸、高频率、高散热、低成本、短交货期等方面的要求越来越严,从而推动了新的封装技术的开发。例如球栅阵列封装(BGA)、芯片倒装焊(Flipchip)、堆叠多芯片技术、系统级封装(SiP)、芯片级封装(CSP)、多芯片组件(MCM)等高密度封装形式将快速发展,高速器件接口、可靠性筛选方法、高效率和低成本的测试技术将逐步普及。
IC封装的简单介绍
IC封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接。封装形式是指安装半导体集成电路芯片用的外壳。它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。
随着封装产品的多样化和高端封装产品的需求增加,我国封测企业在新技术的开发和生产上作出了更多的努力,取得了许多新的进展,逐渐从DIP、QFP等中低端领域向SOP、BGA等高端封装形式延伸,特别是堆叠式(3D)封装技术,已应用于产品生产。MIS封装工艺使金线消耗量显著降低。中国科学院微电子所与深南电路有限公司联合开发的国内首款完全国产化的基于LGA封装的高密度CMMB模块研制成功,达到商业化应用水平。
国集成电路封装测试产业虽然发展迅速,但与我国对集成电路的巨大需求相差甚远,封装能力和技术严重不足,目前国内企业整体技术水平为国际90年代初中期水平,主要IC封装企业的IC封装大多数还处于中低档水平,大部分集成电路封装企业生产的封装产品仍以PDIP、TO、SOP、QFP、QFN、DFN、等中低端产品为主。虽然已经开始先进技术研发,但与国际先进企业存在较大差距。在高端封装技术,尤其是倒装(FlipChip)封装技术,我国刚刚起步,尚未形成大批量生产能力。



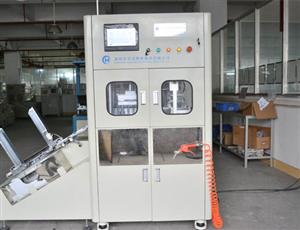




 二维码
二维码

