国内半导体封装清模材料的最新进展及趋势
在一般半导体器件所采用的转移成型封装过程中,清模是一项看似无关紧要,实际上是非常重要的工序。一方面,在连续成型作业中,来自于塑封料以及脱模剂的一部分成分在高温(170℃~180℃)的作用下发生氧化,并且附着在模具表面,形成难以去除的污垢。如果没有及时清除,不但会造成封装时离型困难和封装体外观缺陷,而且会对模腔表面造成损坏。另一方面,每天例行清模过程所耗的少则1~2h,多则3h的时间,对于目前国内大部分封装测试厂而言,相对于订单数量显得捉襟见肘的产能来讲,绝对是一个异常漫长的过程。
尽管国内外专业媒体对于封装技术和封装材料的专论很多,但专门论述清模工序和清模材料的文章却极为鲜见,这未尝不是一件憾事。因而,本文对目前封装行业中所采用的清模材料的最新进展作一总结,同时就其未来的发展趋势发表笔者的一点陋见,如有疏漏之处,还望不吝赐教。
2 两种主要的清模材料
2.1 三聚氰胺
三聚氰胺清模料,一般是比重为1.2~1.5的白色圆柱或条块。同环氧树脂塑封料相类似,是一种热固性材料,可以采用与之相同的塑封参数。其主要成分是:
①三聚氰胺甲醛树脂。一般占重量百分比为60%~70%,构成清模料的主题,具有很好的流动性和一定的粘性。
②固化剂。一般占清模料3%~10%的重量,在湿度的作用下,同三聚氰胺甲醛树脂发生聚合反应。通过增减固化剂的含量,可以调节清模料的固化时间和流动性。
③填料。占20%~40%的重量百分比。一般有两种不同的填料成分:一种是有机填料,主要是纤维;另外一种为无机填料,一般是二氧化硅颗粒。由于三聚氰胺在固化后易碎,所以纤维填料的作用
是增强固化后的强度,避免清模料破裂。而颗粒填料在注塑过程中,与模腔污垢产生刮擦和碰撞,起到研磨的作用。
在清模料中一般还有2%~10%的蜡和添加剂,分别起到离型和增强粘结的作用。
三聚氰胺模料的作用机理有三种:
①粘结作用。三聚氰胺在固化后可以紧紧粘住污垢,并在离型时将污垢从模具表面拉脱。
②研磨作用。在注塑过程中,颗粒填料在胶道和模腔内流过,与污垢发生碰撞和刮擦,从而除去污垢,同时降低污垢与模具表面的附着力。 ③分解作用。部分清模料中所含的添加剂会渗透到污垢内部,使污垢分解,或者降低污垢与模具表面的结合力,从而增强清模效果。
由于三聚氰胺甲醛树脂原料便宜(一般每千克的成本为2.09~2.18美元),所以三聚氰胺的售价不高,一般在每千克9~12美元左右。也正是由于价格的原因,三聚氰胺成为封装行业应用最为广泛的清模材料。
目前生产三聚氰胺清模料的厂家很多,除Nippon Carbide这样的化学品公司外,诸如长春住工、韩国DONGJIN、三星第一毛纺、Cookson等塑封料厂商也生产三聚氰胺清模料。
2.2 清模胶片
传统的清模方法,往往耗时很长,同时也消耗大量的引线框架(或者纸质框架)。为解决这个问题,清模胶片逐渐为封装厂所采用。
对于清模胶片的组成成分,不同的厂商有不同的配方,但经过笔者的调查,大体可以分为如下部分:
①清模胶片的主要成分是未硫化的顺丁橡胶(BR)或者乙丙橡胶(EPR)、其重量百分比大约为50%~70%,在清模流程的温度和压力的作用下,橡胶开始硫化,从而使污垢和橡胶成为一体,在离型的时候将它去除。
同传统的三聚氰胺清模料相比,由于橡胶的粘性要高于三聚氰胺,所以,清模胶片的清模效果要好于三聚氰胺。一般用三聚氰胺需要重复清模8~10次,而如果代之以清模胶片,清洗2~3次就足够了。
②二氧化硅填料,其重量百分比大约为10%~30%。其重要作用是,增强橡胶的强度和抗撕裂性,同时在清模过程中受到挤压以及扩散时,对污垢起到研磨作用。
③硫化剂。
④催化剂和硫化促进剂,以及一定数量的离型剂。
⑤在橡胶中可以加入具有特定亲污垢官能团的添加剂作为清洁助剂,从而使得橡胶与污垢可以更牢固地结合一起,达到更好的清模效果。日本的日东电工对这项技术申请了专利,因而,清洁助剂的技术并未得到广泛采用。
⑥同时,某些清模胶片也采用一定的添加剂,可以分解底层污垢,达到更强的清模效果。如图2所示,模具的污垢构成分为两层结构,其中表层污垢主要是塑封料的组分,相对容易从模具上剥离出来;而底层污垢之中含有脱模剂(石蜡)以及塑封料在高温下的部分碳化产物,同时夹杂了部分模具表面金属镀层的成分,因而,在底层污垢中无机物的含量较高,更难于去除。无论是三聚氰胺还是普通的清模胶条,都无法将底层污垢彻底去除。而某些特殊的添加剂可以渗透到底层污垢内部,将污垢分解,同时降低污垢对于模腔表面的黏附力,从而将底层污垢从模具上剥离。这项技术也属于专利,被日东电工所垄断。
通过以上这些资料,可以总结出清模胶片的作用机理:
物理粘结作用。通过橡胶的粘结作用,将污垢从模具表面拉除;
②化学粘结作用。通过亲污垢官能团(或者清模基团)完成污垢与橡胶的结合;
③机械研磨作用。通过二氧化硅填料在加压后的运动,撞击和研磨污垢;
④分解作用。分解污垢,达到清除底层污垢的目的。
清模胶片的价格较因其制造厂商和品质而异,一般为每千克20~70美元,现有的制造商包括:日东电工、JINYONGTECH、Keeper、SuperCleaning等,同时诸如Donjin、三星第一毛纺等三聚氰胺厂商也在发展清模胶片。
3 三聚氰胺和清模胶片的比较
(1)清模能力
三聚氰胺的粘性要低于橡胶,所以需要反复清模数次才能相对彻底地清楚污垢。相反,清模胶片往往能够2~3次就达到很好的清洁效果。
清模胶片的优越性还在于其不但可以清洁模腔,同时也可以清洁模面和排气口。虽然三聚氰胺也有条块状的产品,可以起到相似的作用,但后者由于容易碎裂,部分残渣会遗留在模腔内形成二次污染,因而其应用还不是十分广泛。
然而,三聚氰胺的优势在于其良好的填充性能。由于采用同塑封相同的注塑方式,三聚氰胺可以充填每个模腔的每一个角落,而对于清模胶片而言,要达到能够填充所有的角落,需要相当的排布胶条的技巧,也是很有难度的。 两种材料都有其离型方面的局限性。三聚氰胺的局限性在于其固化后容易破裂,如果其组分中所含的离型剂的比例不太合理,固化的三聚氰胺残渣很容易粘在模腔上,难于去除,造成二次污染,这也是其成分中加入纤维填料的原因。而清模胶片对于较深、较小的模腔,不但不容易填充,而且也会有破裂的问题。
(2)清模时间
清模胶片的最大优势在于其清模时间短,其典型的固化时间是175℃,300s,重复清洗动作2~4次。这样整个清模时间耗时20~30min。而三聚氰胺典型的固化时间是175℃,300s,需要重复清洗动作6~10次,再加上预热时间,整个清模需要耗时2~3h。
(3)使用和储存
清模胶片的保存温度一般要低于5℃,这同环氧树脂塑封料的储存条件是一样的。而三聚氰胺可以做到常温下储存,这给使用者带来很大的方便。两种材料在高温下都会生活刺激性气味,相比较而言,三聚氰胺的气味更容易接受得多。
(4)成本
单就销售来看,清模胶片的价格要远远高于三聚氰胺清模料。但是,三聚氰胺所需的清模次数要远远多于清模胶片,而且,饼料的三聚氰胺在使用的过程中往往需要消耗不少引线框架(也有的厂商为了降低成本,用纸质框架来代替),清模胶片就没有这个问题。所以,如果真正计算清模流程的直接成本,需要同时考虑到清模材料的单价和清模材料的消耗量,并加上辅助材料的成本。
清模直接成本=清模材料的单价×清模材料的消耗量+辅助材料成本(如框架)=清模材料的单价×(清模次数×单次消耗清模材料的重量)+辅助材料成本
就单次消耗清模材料的重量来看,清模胶片的比重要高于三聚氰胺,此外,为了清模之后顺利地离型,所有供应商都会建议使用清模胶片合模时,上下模之间保留至少1mm的间隙。这样,同饼料的三聚氰胺相比,使用清模胶片需要多消耗模面之间1mm厚的部分。
当然,在估算并比较清模直接成本时,最大的变动因素是清模材料的用量,由于很大部分的清模胶片消耗在模面之间,而根据模具的设计不同,清模片的使用效率也是有很大差别的,例如,对于MAP-BGA而言,模腔几乎占据了整个模面的面积,所以清模片的使用效率自然是最高的,一般而言,封装体的厚度越大,模腔设计越密集,清模片的使用效率就越高。然而,不同的清模片由于清模效果不同,其所需的清模次数也有很大的差异。
根据不同模具厂商提供的数据,笔者估算了各种封装形式相对应两种清模材料消耗量的比例关系。具体见表2。
再综合考虑单价差异和辅助材料的消耗,可以看出,对于SOP、LQFP、QFN、TO等封装形式,两种方案的清模成本相差不多;对于BGA、DIP、QFP等较大的封装而言,如果模具设计合理,使用清模胶片甚至是更为节省的方案;但是对于体积较小的分立器件和TSSOP/SSOP,使用三聚氰胺是比较经济的方案。
4 国内半导体封装业清模材料应用的现状
目前在国内半导体封装行业对清模材料的总需求量大约是每月38×103kg,其中约有32×103kg为三聚氰胺,另外的5×103kg多是清模胶片。
从图3中可以看出,SOP/QFP的厂商似乎对清模胶片的接受程度很高,可能是考虑到清模胶片的清模成本较低且利于提高产能的缘故。 DIP和分立器件的厂商还是以三聚氰胺作为首选,相信是由于产品的利润不高,而且对于清模效果的要求不是太严格,所以无法接受清模胶片的高价格。
对于BGA和T/LQFP而言,由于国内总体的产量还不是很多,所以两种清模料的用量都不大,而光电器件和智能卡产品在国内更是方兴未艾。这些产品对于清模胶片的接受程度较高。由于智能卡产品为避免昂贵的框架材料消耗,更是将清模胶片作为主要的材料。
5 清模材料的发展趋势
5.1 绿色封装对于清模材料的挑战
绿色封装的环保要求引发了环氧树脂塑封料的更新换代,在旧有塑封料中所广泛采用的Sb2O3阻燃剂被金属氧化物或者其他方案所替代,而由于无铅焊接所产生的更高的耐潮气性(MSL)要求使得树脂材料也随之变化。不论众多的塑封料厂家所开发的绿色塑封料组成如何,我们都可以发现这样的趋势:①为了引入更高的填料含量,更低黏度的树脂材料被采用;②为防止更严苛温湿试验中的分层,塑封料的粘接性能不断加强。
无论是以上哪种改变,对于封装厂而言,塑封料的粘性增强了,因此引发的粘模问题也接踵而来。不少绿色封装业者抱怨原本800~900个shots清模一次,变成了每400个shots清模一次。
就清模材料业者而言,尽管对材料的需求会因为清模次数的增加而升高。但他们也有苦恼,因为清模材料不仅需要解决如何能够有效地将粘结在模具表面的塑封料清干净的问题,还面对着减少清模时间从而提高了封装厂产能的问题。
5.2 其他清洗技术的进步
除了本文主要讲述的两种清模材料以外,其他的清模方法也在改进当中。
(1)传统的化学清洗可能会变的更加方便
在模具翻新中历来采用NaOH溶液乳化法或者N甲苯基吡咯烷、氨丙醇等溶剂加热溶解法。但是如果在日常制程中采用,则要不断拆装模具,同时化学方法会进入杂质离子,造成产品电性能的失效。但仍然有业者开始研究喷洗的方式,毕竟化学清洗的效果还是颇吸引人的。
(2)机械清洗方法的改进
某些设备制造商对在普通注塑模具喷砂清洗方法进行改进,力图使之可以适用于半导体封装模具。同时,ASA也在不遗余力的推销它的激光清洗机。如果可以不拆除模具操作的话,无论是三聚氰胺、橡胶片还是化学清洗相比,机械清洗的方法都算得上是很高效的。更何况,在提倡环保的今天,机械或者激光清洗更避免了资源的浪费和化学品产生的污染。当然,这也需要封装厂更多的固定投入。
5.3 清模材料需求的预测
化学清洗和机械清洗都还不太成熟,或无法方便地使用。所以,无论是由绿色封装的增长所引发,还是受中国半导体封装行业超过20%的年增长率所带动,清模材料的需求都将会稳步增长。
根据笔者预测,SOP和QFP绿色环氧树脂的采用以及非绿色要求产品产量的高速增长,将会拉动清模胶片年增长率到40%左右。而LQFP、QFN、BGA所用的清模料中,清模胶片将逐渐成为主角,但因为这些产品的基数不大,所以对清模胶片的增量影响有限。
同时,虽然清模材料总体需求将呈现上升趋势,但总体增量并不会在三聚氰胺清模料上得到太多体现,预计三年内,三聚氰胺将保持3%左右的年增长率。之后,随着竞争产品的逐渐成熟,对三聚氰胺的需求甚至会出现下滑的趋势。
6 结论
本文所主要论述的两种清模材料在相当长的一段时间内,将保持在半导体封装模具清洗市场的主导地位。而如何提高清模效果和生产效率,同时降低封装厂的成本,将是清模材料的长期任务。
而对于橡胶清模片这个新贵而言,要真正占据主导地位,还需要继续进行自身的完善,针对小模腔的填充问题提出更好的解决方案,同时降低成本。但无论如何,对于提高封装厂的生产效率而言,它具有先天的优势。



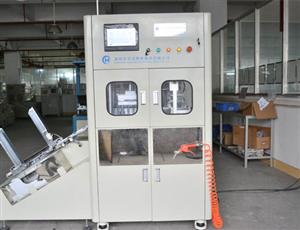




 二维码
二维码

